半導體矽晶片超(chāo)精密加(jiā)工研究
矽是具有金剛石晶體結構,原子間以共價鍵(jiàn)結合的硬脆材料。其硬度達1000HV,但斷裂強度(dù)很低,超精(jīng)密加工這樣(yàng)的硬脆材料有一定(dìng)的難度。同時,矽又是一種很(hěn)好的半導體材料,構成(chéng)集成電路半導體晶片(芯片)的90%以上都是矽晶片。以信息網絡為代表的信(xìn)息革(gé)命浪(làng)潮,正在各(gè)方麵推(tuī)動著社會進(jìn)步,改變著人們的生活(huó)方(fāng)式,提高人們的生活水平。所有這些進步和發展,主要由(yóu)半導體矽片上所(suǒ)製(zhì)成的微細集成電(diàn)路芯片及由(yóu)各種芯片器件製成的各種電(diàn)器所(suǒ)引起和推動的(de)。
另(lìng)外,在現(xiàn)代國防和軍事方麵,電子信息化武裝的武器裝備在現代戰爭中發揮著越來越重要的作用,甚至起著決定戰爭勝負的關(guān)鍵性作用。所有(yǒu)這一切的發展和需要(yào),都是建立在半導體矽材料的基礎之上。半導體矽材料是半導體工業最(zuì)重要的主體(tǐ)功能材料,是第一大功能電子材料,至今全球矽材料的使用仍占半(bàn)導體材料(liào)總量的95%以上。矽材料、矽器件和(hé)矽集成電路的(de)發展與應用水平早已成為一個國家的國力(lì)、國防、國(guó)民經濟現代化(huà)及(jí)人民生(shēng)活水平(píng)的(de)重(chóng)要標誌。集成(chéng)電路自 1959 年發明以(yǐ)來,集成電路芯(xīn)片 的集成度在(zài)不斷提高,而加工特征尺寸和加工成 本逐(zhú)步縮小[2],如表 1 所示。
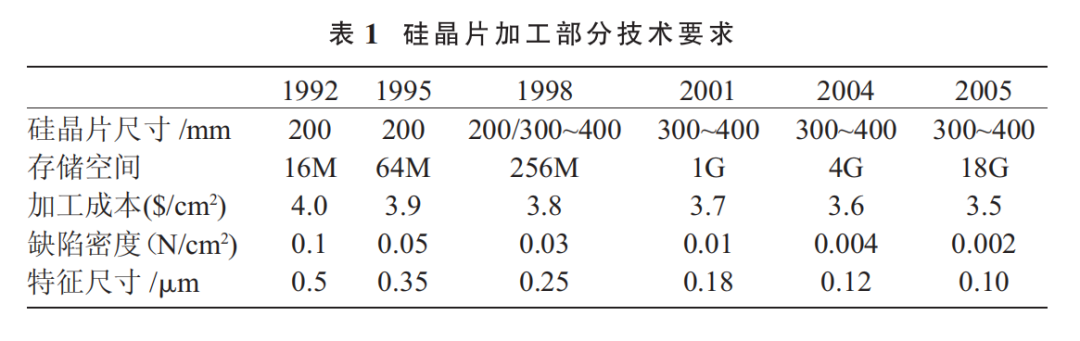
為了能在矽晶片上(shàng)印刷集成電路、與其他元件結合緊密,矽晶片的表麵必須平直;特別是隨著(zhe)集成電路集成度的提高,對矽晶片表麵(miàn)的線寬、矽(guī)晶片的平直度提出了越來越(yuè)高(gāo)的要求;而且企業(yè)為了占領市場,實現優質、低耗、大尺寸、高精度的矽晶片超精密加(jiā)工具有極其重要的意義。
超精密加工的加工機(jī)理主要包括“進化加工”及“超越性加工”。目前除對(duì)機理研究外,還對微觀 表麵完整性,在超精密範疇內對各(gè)種(zhǒng)材料的(de)加工(gōng)過程、現象、性能以及工藝參數進行提示性研究。由於直接對切削點觀察異常困難,現在有提議將切削裝置小(xiǎo)型(xíng)化,放置(zhì)於SEM的鏡頭下進行切削並觀察。日本大阪大學井川(chuān)直哉教授等開始采用 計算機仿真,逐步向(xiàng)揭(jiē)開微量切削的(de)奧秘迫(pò)近。超(chāo)精密加工方法主要(yào)包括超精密切削(xuē)(車、銑)、超精密磨削、超精密研磨(mó)(機械(xiè)研磨、化(huà)學機械研磨、非接觸式浮動研磨、彈(dàn)性(xìng)發射加工等)以及超精密特種加工(電子束、離子(zǐ)束以(yǐ)及(jí)激光束加工等)。而且在今後的相當一段時間(jiān),亞(yà)微米(mǐ)及納米級製造及測(cè)量成為製造科技和製造工藝的主流。
矽晶片主要研究方法(fǎ)及現狀
1.1 矽晶片的形成生產矽晶(jīng)片從製作矽錠開始,這可能需要一周至一個月的時間。75%以上的單晶矽(guī)片使用(yòng)切(qiē)克勞斯(sī)基直拉(CZ)法製成。將大塊的多晶矽與少量摻雜劑一起放入石英坩堝內即(jí)可製出矽錠(dìng)。多晶矽通過氯代矽烷(wán)和氫氣(qì)的複合(hé)還原及純化處理從砂石中提煉出(chū)來。摻(chān)雜劑使矽錠具有期望的電學(xué)特性並決定矽錠(dìng)的類型 (P 或 N)。單晶拉製是將(jiāng)大(dà)塊的多晶矽與少量摻雜劑一起放入熔爐石英(yīng)坩堝內。多晶(jīng)矽在高純度氬氣流中、1400 ℃加工(gōng)溫度(dù)下融化(huà)。當其成為(wéi)熔體時,即相當於一(yī)顆單晶矽片的“種子”灑落(luò)在了熔體中並且被(bèi)慢慢地拔(bá)出。種子的表麵張力(lì)使小量熔融的矽晶體(tǐ)與種子一起升起,形成一個理想的、與種子(zǐ)具有相同晶體定向的單晶(jīng)錠塊(kuài)。成形的單晶錠塊被打(dǎ)磨(mó)成(chéng)大致的直徑尺寸,順著錠塊長度方向呈現“鋸齒狀”或(huò) “扁平狀”,據此形狀可判斷錠塊的結晶定向。切割使用金剛石圓鋸將晶棒切割成晶片。邊緣(yuán)打磨(mó)加工矽晶片時一個非常重要的步驟就是(shì)在後續加工過程或以後的元件製作過程中減少晶片的破損。初成形的晶片邊緣都是經過充分打磨,這樣做可(kě)以大大地改善清洗效果並減少破損,有效率達 400%。研磨晶片在切割過後十分粗糙,兩邊均有鋸過的痕跡和瑕疵。研磨處理(lǐ)可去除晶片表麵的鋸痕和(hé)瑕疵(cī),同時能(néng)夠緩解(jiě)切(qiē)割(gē)過程積聚在(zài)晶片(piàn)中的應力。研(yán)磨(mó)過(guò)程還會導致出現裂(liè)紋以(yǐ)及其他 相關現象,通過蝕刻和清洗,用氫氧化鈉溶(róng)液或乙酸、硝(xiāo)酸混合溶液(yè)去除研磨造成的細裂縫和表麵破損,然後用去(qù)離子水衝(chōng)洗。拋光過程包括幾個步驟,需要使用越來越(yuè)細的漿料(拋光劑)。晶片(piàn)可進行正麵拋(pāo)光(guāng),也可雙(shuāng)麵拋光。拋光處理前對晶片進行多晶矽包(bāo)覆、吹(chuī)砂(shā)或毛刷損傷等“背麵損傷”處(chù)理,目的是為了“收集瑕疵”,將矽晶片的瑕疵拉向晶片背麵,而遠(yuǎn)離要加放元(yuán)器件的正麵(miàn)。最終清洗,該步驟(zhòu)去除晶片上大量的金屬、殘渣以及顆粒物。清洗方法為 RCA,於 20 世(shì)紀 70 年代所(suǒ)研製。第一步稱為(wéi) SC1,依次使用氨水、稀氫氟酸、去 離子水清洗。下一步 SC2 清(qīng)洗包括依次使用鹽 酸、雙氧(yǎng)水、去離子水清(qīng)洗。
清洗(xǐ)處理後晶片最後進行雙麵擦洗,去掉最小的顆粒(lì)物。矽晶片經過(guò)以下過程形(xíng)成:多晶體矽→極限拉伸(局域拉伸)→單晶體矽柱→外圓磨削(無心磨削)→磨削切斷(精密切割)→圓邊→矽晶片
●拉單晶工序:融化 → 頸部(bù)成長 → 晶冠成長 → 晶體成長 → 尾部成長(zhǎng)。
●晶棒裁切與檢測:將長成的晶棒去掉直徑偏(piān)小的頭、尾部分,並對尺寸(cùn)進行檢測,以決定下步加工的工藝參數。
●外徑磨削:由於(yú)在晶棒成長過程中,其(qí)外徑尺寸和圓度均有一定偏差,其外圓柱麵也凸(tū)凹不平,所以必(bì)須(xū)對外徑進行修整、研磨,使其尺寸、形狀(zhuàng)誤(wù)差(chà)均小於允許偏差。
●切斷:由於矽的硬度非常大,所以在本(běn)工序裏,采用(yòng)環狀,其內徑邊緣鑲嵌有鑽石顆粒的薄片鋸片將(jiāng)晶棒切割成一片片(piàn)薄片。
●圓邊:初切割的晶片外邊緣很鋒利,矽單晶又(yòu)是脆性材料,為避免邊角崩裂影響晶片強度、破壞表(biǎo)麵光潔和對後工序帶來汙染顆粒,必(bì)須用專(zhuān) 用的電腦控製設(shè)備(bèi)自動修整(zhěng)晶片邊緣形狀和外徑尺寸(cùn)。
1.2 矽晶片的傳統加工工藝矽晶(jīng)片加工是 IC 製(zhì)造係統重要的基礎環節, 矽片的加工精度、表麵(miàn)粗(cū)糙度和表麵完整性直接影響(xiǎng) IC 的線寬和 IC 的(de)性能,對於<200 mm 的矽 片,傳統的加工工藝(yì)過程為:切片→倒角→研磨→ 腐蝕→清洗→拋光(guāng)(如圖 1 所示)。由於采用內圓金剛石鋸片切割會產生較大的(de)翹曲變(biàn)形,最大翹曲量達到 37 μm,矽片表麵還會殘留切痕和(hé)微裂痕,損傷層深度可(kě)達(dá) 10~50 μm,經雙麵研磨機平整化加工後可使矽片厚度公差小於 3 μm,總厚度 變化 TTV<1 μm,平整度<1 μm,但表麵粗糙度 為 0.1~0.2 μm,達不到要求,需經過後續(xù)的腐蝕去除研磨所產生的(de)表麵損傷層,最後(hòu)經過化學機械拋光獲(huò)得超(chāo)光滑(huá)無損傷(shāng)表麵。
1.3 矽晶片的超精密加工(gōng)經過上述過程所形成的(de)矽晶片,其平麵度小於 8 μm,但還需(xū)進一步加工,以提(tí)高其平麵度和降低表麵粗糙度。其主要過程為粗磨→精(jīng)磨→化學刻(kè)蝕→拋光→電路層(céng)製作→背麵磨削→切割成小塊。
1.3.1 超精密切削研究現(xiàn)狀單點金剛石切削(SPDT)。單點金剛石切削的特點是采用數控方法直接控製加工輪(lún)廓和表麵粗糙度,是加工紅外光(guāng)學材料和磨削加工(gōng)的可替代(dài)方法。Venkatesh 等人采用 0°前(qián)角、刀尖半徑為 0.75 mm 的(de)金剛石刀具加工矽晶片,當切削深度為 1 mm、進給速度為 0.4 mm/min、主軸速度為 400 m/min 時,采用 AFM 測量方(fāng)法,所(suǒ)得到(dào)的表麵粗(cū)糙度達到 1 nm[7]。金剛石切削刀具刃口圓弧半(bàn)徑一直在向更小 的方向(xiàng)發展,因為(wéi)它的大(dà)小直(zhí)接(jiē)影響到(dào)被加工表麵的粗糙度,同時還必然要求金剛石刀具更加鋒利。根據日本大阪大學島田尚一博士介紹,為了進行切(qiē)薄試驗,目標是達到切(qiē)屑的厚度 1 nm,其刃口圓(yuán)弧半徑趨近 2~4 nm。為解決金剛石刀具的磨(mó)損問題(tí),Jiwang Yan 等(děng)人提出采用倒角金剛石刀具大進給塑性(xìng)加(jiā)工單晶矽,在(zài)進給量為(wéi) 5 mm/min 的加工條件下得到的 SEM 連續切屑,加工表麵粗糙度 Ra = 5.1 nm[8]。這(zhè)一(yī)方法對於推廣單點切削的生(shēng)產應用(yòng)具有重(chóng)要意義。
1.3.2 超精(jīng)密磨削研究現狀(zhuàng) (1)矽片自旋轉磨削。采用略大於矽片的工件轉台,通過真空吸盤每次裝夾一個(gè)矽片,矽片的中心(xīn)與轉台的中心重合,杯形金剛石砂輪的工作麵調整到矽片的中心位置。磨削時,矽(guī)片和砂輪繞各(gè)自的軸線回轉,砂輪隻進行軸向(xiàng)進給。在超精密磨削中,金剛石砂輪的修整情況對零件的加工質量有決定性影響(xiǎng)。其修整過程主要包括修平 / 結合劑去除(chú)和去尖,修平一般采用金剛石砂輪磨削相(xiàng)對軟質(zhì)物質。結合劑去(qù)除主要采 用電解法(fǎ)和接觸放電法。目前,采用矽片自旋轉磨削方法加工直(zhí)徑 150~ 400 mm(6~16 英寸)矽片,可實現矽片的正麵超精密磨削和背麵磨削減薄,所達到的技術指標見表 2。
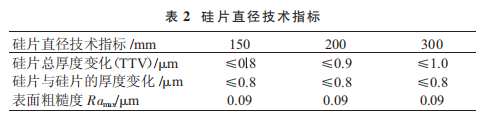
1~20 nm,亞(yà)表麵損傷深度隻有傳統磨削的 1%~2%,甚至小於拋光加工產生的亞表麵損傷深度。由於(yú) Tetraform“C”型磨床結構(gòu)方麵的原因,Cranfield 大學與 Cranfield 精密工程有限公司聯合研製成功一種新型的矽片超(chāo)精密磨床(見(jiàn)圖 3),該磨床(chuáng)為敞開臥式結構,並(bìng)采取控溫、隔振等措施,可在一個工序中以很高的加工效率完成 矽片的塑性域納米磨削,獲得很好的表麵和(hé)亞表麵完整性。據稱,用該磨床超精密(mì)磨削大尺寸矽片可以完全代替傳統工藝的研磨和腐蝕工序,甚至有(yǒu)望代替拋光加工。(2)微粉(fěn)金剛(gāng)石磨盤的研磨和拋光工藝:A. 高剛度的固著磨料盤安裝在磨拋液槽的底部(bù);B. 磨拋主軸采用高精度高剛度(dù)空氣軸承,Z 向采用高剛度(dù)的(de)微進給控製係統,保證工件與磨拋主(zhǔ)軸間(jiān)的位置精度;C. 磨拋運動由工件的旋轉(zhuǎn)和工(gōng)作台在 X-Y 方向的高精度運動組成;D. 通(tōng)過測力平台精密檢測過程中的磨(mó)拋力,可進行超低載荷磨拋加工;E. 采用磨拋液循(xún)環(huán)過濾和溫度控製係統,排除磨拋液中的廢屑和保持磨拋液溫(wēn)度恒定。F. 利用磨拋液的(de)化學作用和磨盤的機械作用,通過控製壓力進行矽片超精(jīng)密平整化加工,在正常磨拋壓力下,大直徑矽片的平麵度可控製在 5~50 nm 之間。1.3.2 超精密研(yán)磨研究現狀(zhuàng)在包括機械化學研磨(Chemical-Mechanical Polishing)、非接觸式浮動研磨、彈性發射加工等 超精密研削中,機械化學研磨的應用比較廣泛。其工作原理是由溶液的腐蝕作用形成化學反應薄層,然後由磨(mó)粒的機械摩擦(cā)作(zuò)用去除。利用軟磨料的活性以及因磨粒與工件間在微觀接觸度的摩擦產生的高壓(yā)、高溫,使能在很(hěn)短的接觸時間內出(chū)現固相反應,隨後這種反應生成物被運動的磨粒機械摩擦作用去除。目前去除量最小至 0.1 nm,整體厚度變化為(0.2~0.4)μm/300 mm, 表(biǎo)麵光潔度為 1 nm。
圖 4 為用 AFM 測得的表麵 粗糙度。英國和德國對這項(xiàng)技術的研究處(chù)於領先地位。
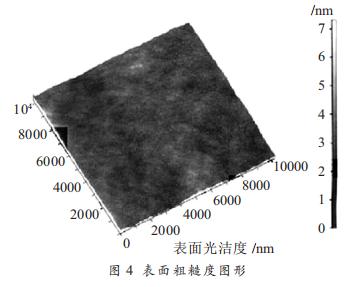
圖(tú) 5(a)、圖(tú) 5(b)、圖 5(c)為矽片的粗磨、超精(jīng)密磨削(xuē)和超精密磨拋加工及其(qí)表麵損傷層。
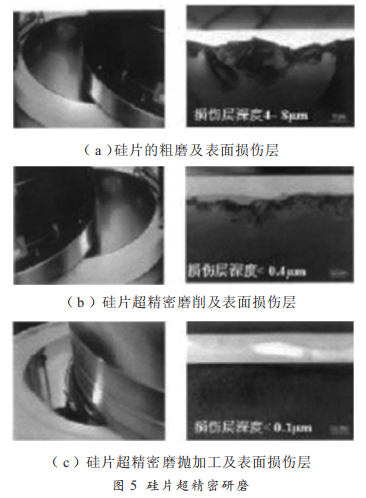
3 矽片的(de)超精密拋光技術
3.1化學(xué)機械拋光
化學機(jī)械拋光時,旋(xuán)轉的工件以(yǐ)一定的壓力壓在旋轉的(de)拋光墊上,而由微米或納米磨粒和化學溶液組成的拋光液在(zài)工件與拋(pāo)光墊之間流動,並產生化學反應(yīng),工件表麵形成的化學反應(yīng)由磨粒的機械作用去除,即在化學成膜和機械去膜的 交替過程中實現超精密(mì)表麵加工(gōng)———遊離磨料CMP。CMP加工過程中,矽片表麵各點的拋光壓力分布是不均勻的,這成為影(yǐng)響矽片CMP平整化加工均(jun1)勻(yún)性的重要因素,夾持和(hé)固(gù)定矽片的夾盤和背襯表麵平整度直接影響拋光(guāng)矽片的平整度(dù)。日(rì)本Tokyo Seimitsu公司應用氣壓控製技(jì)術開發了浮式矽片夾盤,不需要高(gāo)精度的平(píng)整背襯,通過在夾盤中形成的氣墊支撐矽片(piàn)的背麵,以保證(zhèng)拋光過程中均(jun1)勻的壓力分布。
3.2等(děng)離子輔助化學刻蝕平坦化技術
測量係統把矽片表(biǎo)麵凹凸的幾何誤差信息輸入計算機,由計算機控製(zhì)等離子噴嘴的(de)位(wèi)置和速度,對凸凹表麵進行局部加工,刻蝕速度一(yī)般為(wéi)1~50 mm/min,等離子噴嘴直徑可以從3~30 mm選(xuǎn)擇,對精度進行控(kòng)製。
3.3電化學機械平坦化技術
在傳統的電化學銅沉積(jī)工藝基礎上,在兩個電極之間增加非導體多(duō)空拋光(guāng)墊,利(lì)用拋光(guāng)墊的幹擾作用實現選擇性電化學銅沉(chén)積(jī),同時拋光墊的機械摩擦和拋光(guāng)作用可去除(chú)頂部多餘的銅沉積層,從(cóng)而通過選擇沉積於機械去除雙重(chóng)作用(yòng),減少多餘銅的厚(hòu)度,達到平坦化的目的。
3.4無應力拋(pāo)光技術由電解拋光技術發展而來,依靠電流密度效應按一(yī)係列同心環對銅結構表麵進行平坦化。其工藝過程為:首先利(lì)用電解拋光(guāng)去除大(dà)量的銅;再通過二次拋光,以確保全部去除頂部的銅(tóng);最後采用等離(lí)子體刻蝕工藝(yì)去除頂部的阻擋層金屬,並 回蝕某些電介質。
4矽晶片加工設備的研究現狀
美國LLL實驗室於1983年研製的DTM-3大型金剛石超精密車床,加工平(píng)麵(miàn)度為12.5 nm,加工表麵粗糙度Ra為4.2 nm。英國克蘭菲爾德(Cranfield)技術學院所屬的(de)克蘭菲爾德精密工程研究所(簡稱CUPE)是當今世界上精密(mì)工程(chéng)的研究中心之一,是英國超(chāo)精密加工技術水平的(de)獨特代表。其生產(chǎn)的Nanocentre(納米加工中心)既可以進行超精(jīng)密車削,也可以進行超精密磨削,加工工件的形狀精度為0.1 nm,表麵粗糙度小於10nm。模塊化、構建化是超精密機床進入(rù)市場的重要技術(shù)手段,如美國ANORAD公司生產各種主軸、導軌和轉台,用戶可根據各自的需要組(zǔ)成一維(wéi)、二維和多維超精(jīng)密運動控製平台和機床。超精密機床往往與傳統機床在結構布局上有很大差別(bié),流行的布局方式是“T”型布局,這種布局使機床整(zhěng)體剛度較(jiào)高,控製也相對容易,如(rú)Pneumo公司生產的大(dà)部分超精密車床都采用這一布局。模塊化使機床布局更加靈活多變,如日本超矽晶體研(yán)究(jiū)株式會社研製的超精密磨床,用於磨削超大矽晶片(piàn),采用三(sān)角(jiǎo)菱形五麵體結構,用於(yú)提高剛度;德國蔡司公司(sī)研製了4軸AS100精(jīng)密磨床,用(yòng)於加工自由形成表麵,該機床除了X、Z和C軸外,附加(jiā)了A軸,用於加工自由表麵時控製砂輪(lún)的切削點。
5矽晶片加工方法的發展趨勢
(1)雙麵研磨和采用杯形砂輪的回(huí)轉磨削可進一(yī)步提(tí)高矽晶片的表麵質量,是未(wèi)來(lái)矽晶片超 精密加工很(hěn)有競爭力的技術;(2)在磨削過程中,通過控製刀具相對(duì)於工件的位置和刀具(jù)主軸的自動調整來獲得理想的加工表麵,實現以(yǐ)磨代拋;(3)為進一步提高矽晶片的表麵(miàn)質量,大摩擦係數的化學機(jī)械拋光有可能得到應用;(4)對於大尺寸的矽晶片,如果利(lì)用固定金剛石(shí)刀具進行塑(sù)性區域加工,可提高加工精度,減小亞表麵的損傷,減小拋光量,提高加工效率;(5)用超精密切削代替超(chāo)精密磨削也是超精(jīng)密技術發展(zhǎn)方向之一(yī)。


